La salle blanche regroupe l’ensemble des équipements et des procédés technologiques (chimie, photolithographie, dépôts, gravures, …) destinés à la préparation de substrats et la fabrication de composants micro- et optoélectroniques. La réalisation d’objets ou de dispositifs de petite dimension (micro- ou nanométrique) requiert des conditions de propreté indispensables. Afin de réaliser ces procédés, il est donc nécessaire de travailler dans une zone à atmosphère contrôlée (taux de particules, température, humidité et pression). En amont de l’épitaxie, la lithographie optique est utilisée pour structurer les substrats1 afin de réduire les contraintes dans les structures réalisées et ainsi de limiter l’apparition des dislocations et des fissures. Après une épitaxie, la salle blanche peut être utilisée pour réaliser des objets 3D tels que des micro-disques2 sur lesquels une croissance pourra être de nouveau réalisée. D’autre part, des motifs avec des résolutions de l’ordre de quelques nanomètres peuvent être dessinés grâce à la lithographie électronique3, permettant notamment la réalisation de méta-surfaces. Enfin, en aval de l’épitaxie, la salle blanche permet la réalisation de dispositifs4 micro- et opto-électroniques tels que les transistors à haute mobilité électronique et les diodes électroluminescentes.
1) Structuration de substrats
Exemples de structuration du substrat par lithographie optique, avant la croissance épitaxiale.
Des guides d’onde en GaN ou ZnO pour la photonique intégrée sont réalisés sur des bandes (26/4µm)
1,7µm de profondeur de substrat ZnO (figure 1) ou des bandes de 7/3µm de substrat Si (figure 2).
Figure 3: Un substrat de Si patterné en mesas 200µm*200µm, espacés de tranchées de 10µm de large et
5µm de profondeur.

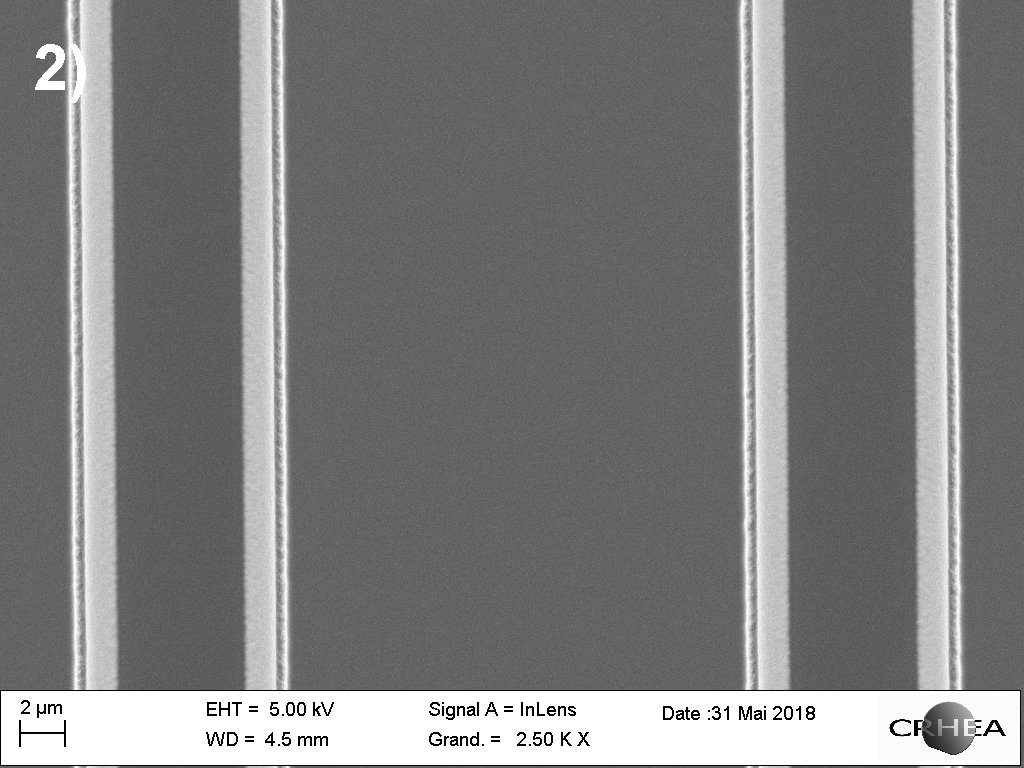
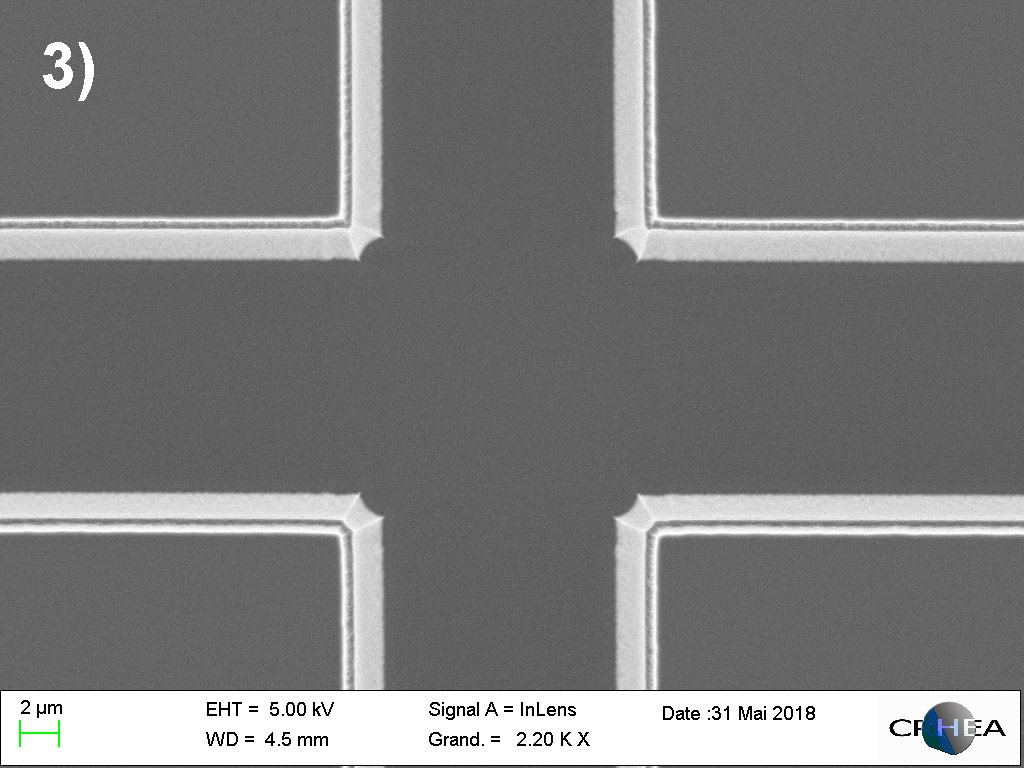
2) Réalisation de micro-disques de semiconducteurs
La gravure sélective de films minces semiconducteurs hétéro-épitaxiés permet la réalisation de
micro-disques qu’on retrouve dans des dispositifs micro- et opto-électroniques avancés (MEMS et MOEMS).
Figure 1: Micro-disques SiC sur Si.
Figure 2: Epitaxie de GaN sur micro-disques d’AlN, avec pour objectif de développer des facettes GaN
semi-polaires sur silicium pour fabriquer des LEDs émettant à grande longueur d’onde. Les plans
semi-polaires du GaN permettent en effet d’incorporer plus d’indium que les plans polaires et la structuration
3D du GaN permet d’éliminer les contraintes extensives responsables de la fissuration des couches GaN épitaxiées
sur silicium.
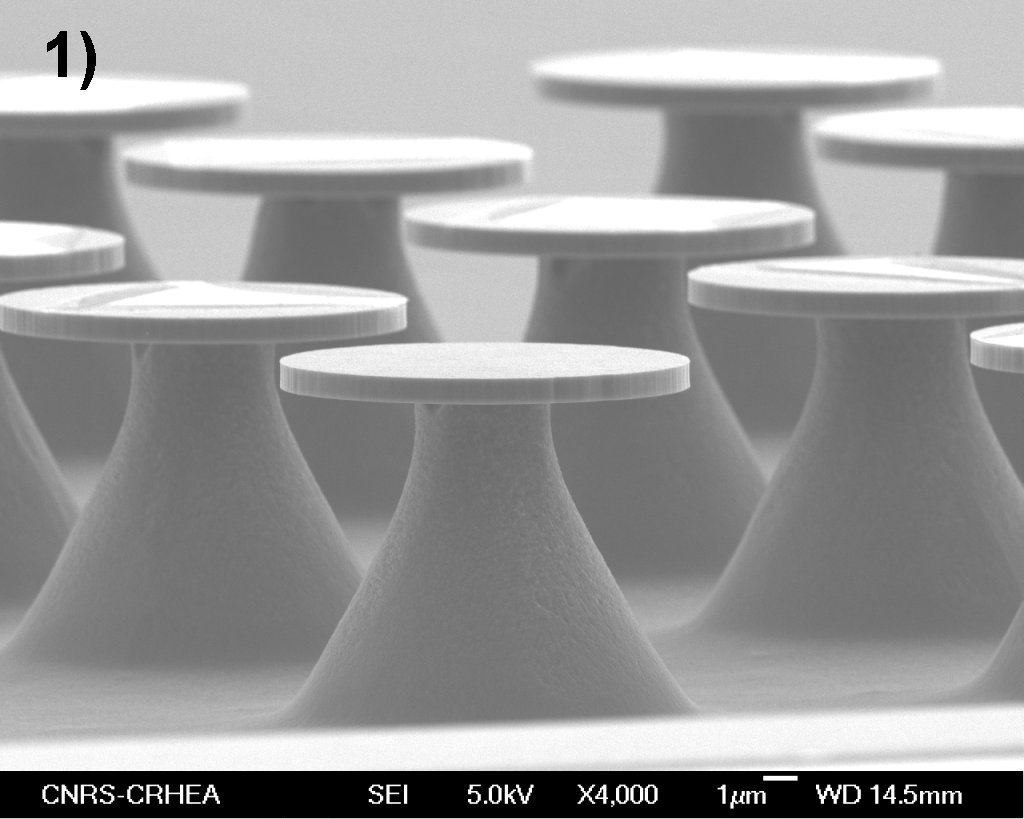
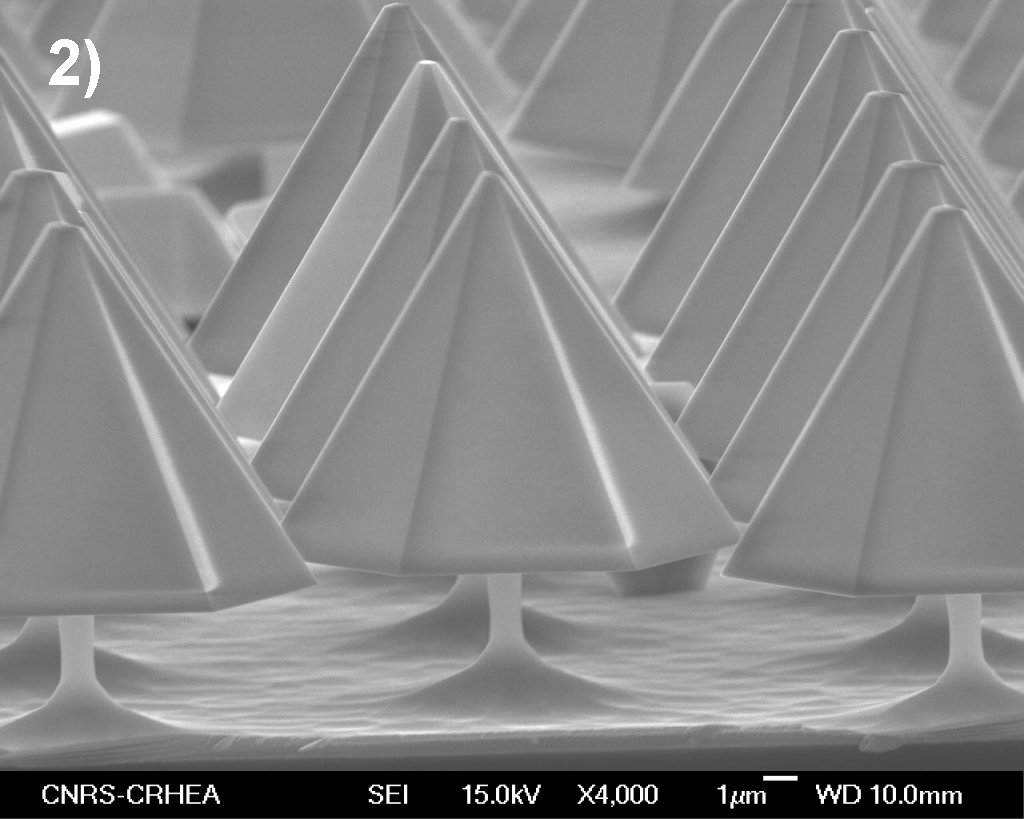
3) Lithographie électronique
La lithographie par faisceau d’électrons est une technique qui permet de dessiner des motifs
avec des résolutions de l’ordre de quelques nanomètres, et de réaliser des objets tels que
des grilles pour des transistors à hautes fréquences, des fils nanométriques (de meilleure
qualité cristalline que des films), ou des méta-surfaces.
Figure 1: Grille de 100nm à 200nm d’un transistor HEMTs GaN/AlGaN.
Figure 2: Croissance de nanofils de GaN avec un masque diélectrique patterné de SiO2 comportant
des trous de 100nm de diamètre, espacés de 500nm.
Méta-lentille convergente de 200µm de diamètre (figure 3) à base de piliers de GaN de 50nm à 100nm de diamètre (figure 4).
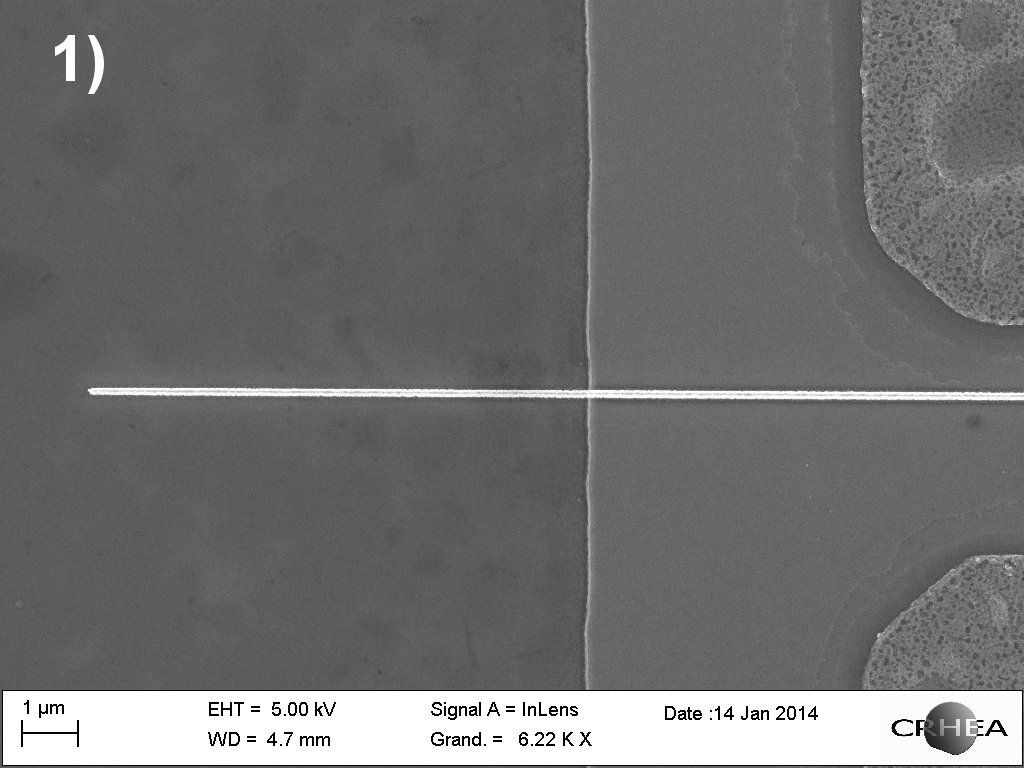
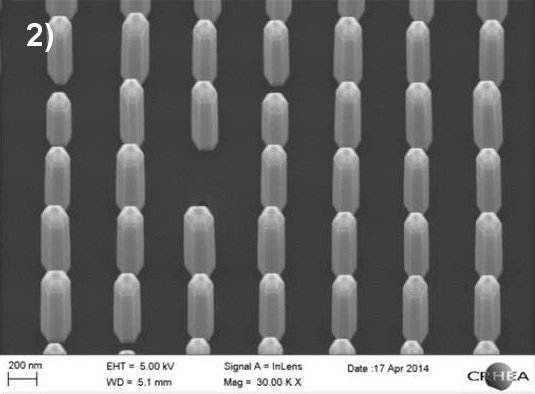
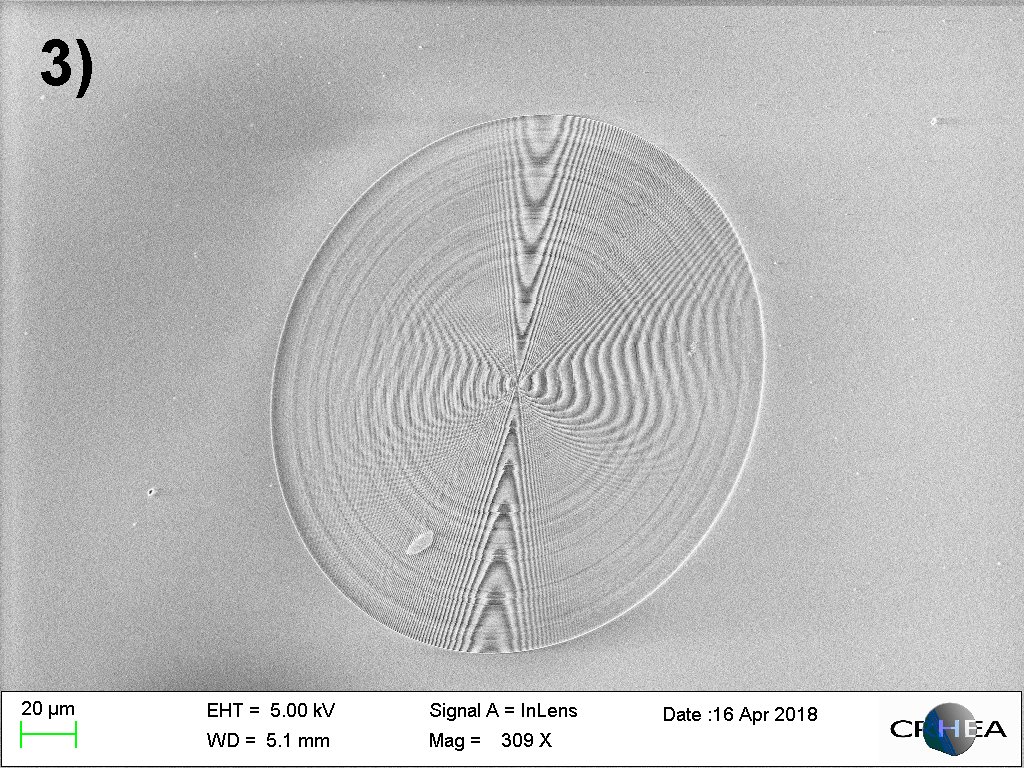
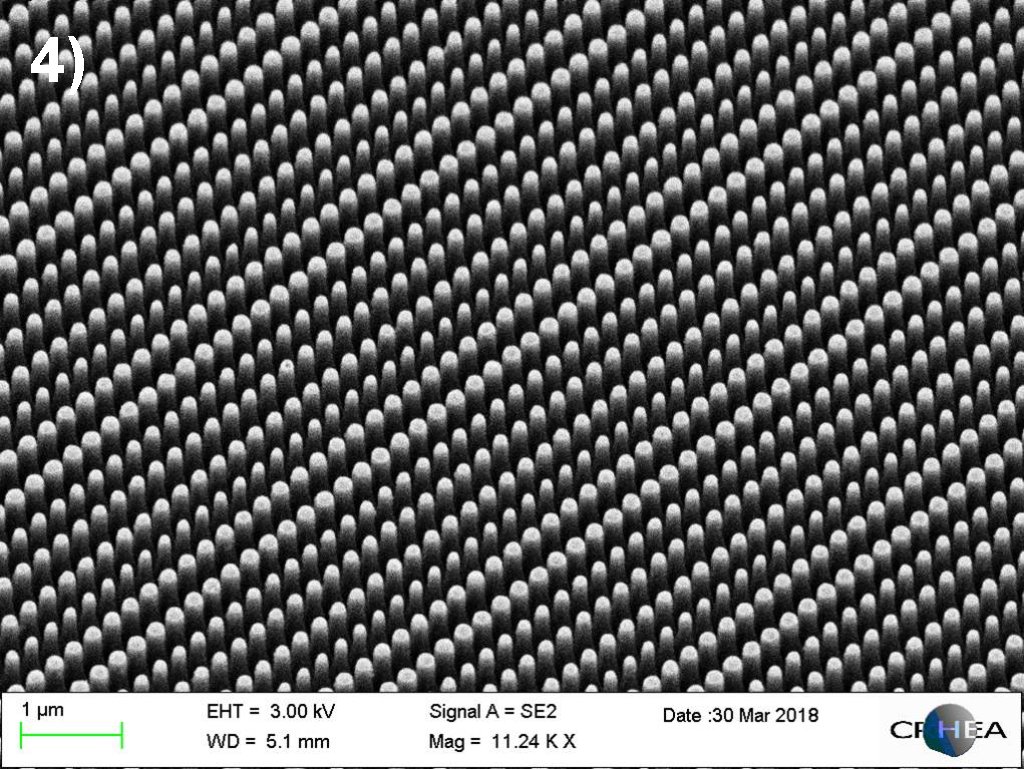
4) Réalisation de dispositifs
La fabrication de dispositifs, tels que les diodes électroluminescentes (DELs) ou les transistors HEMT
(High Electron Mobility Transistor), combine des étapes de chimie et de photolithographie (avec alignement
de plusieurs niveaux de masques, de gravure plasma physico-chimique de mesas, de dépôt de contacts par
évaporation à canon à électrons, et de traitements thermiques).
Figure 1: DEL à base nitrure de gallium.
Figure 2: HEMT GaN/AlGaN.
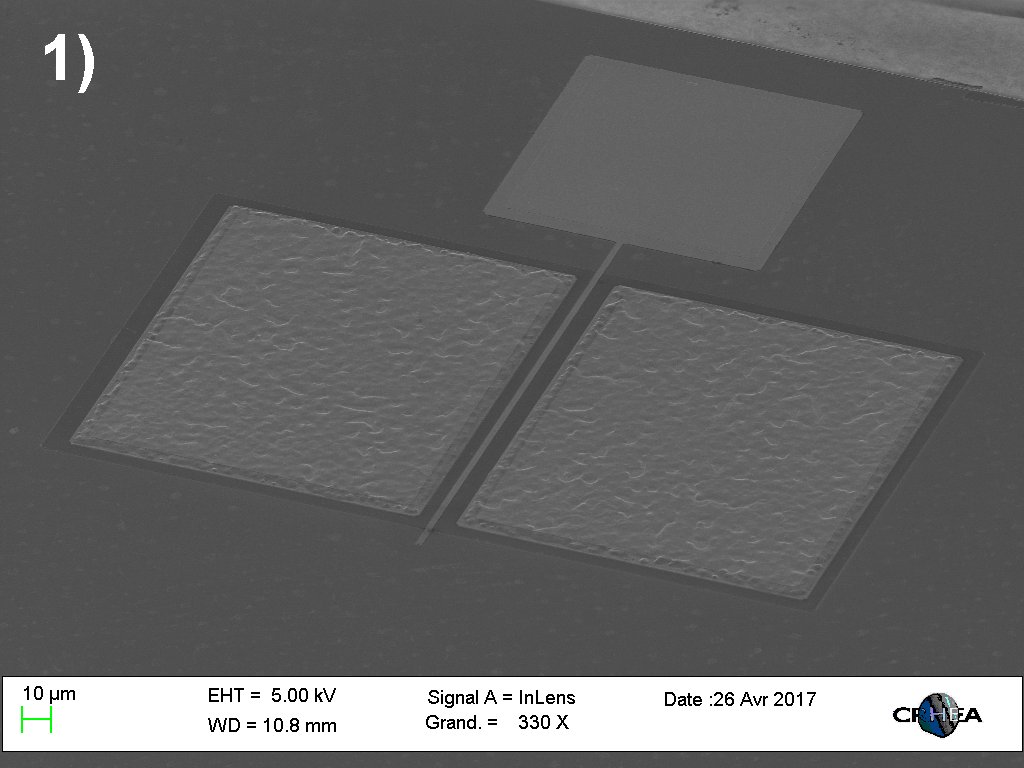
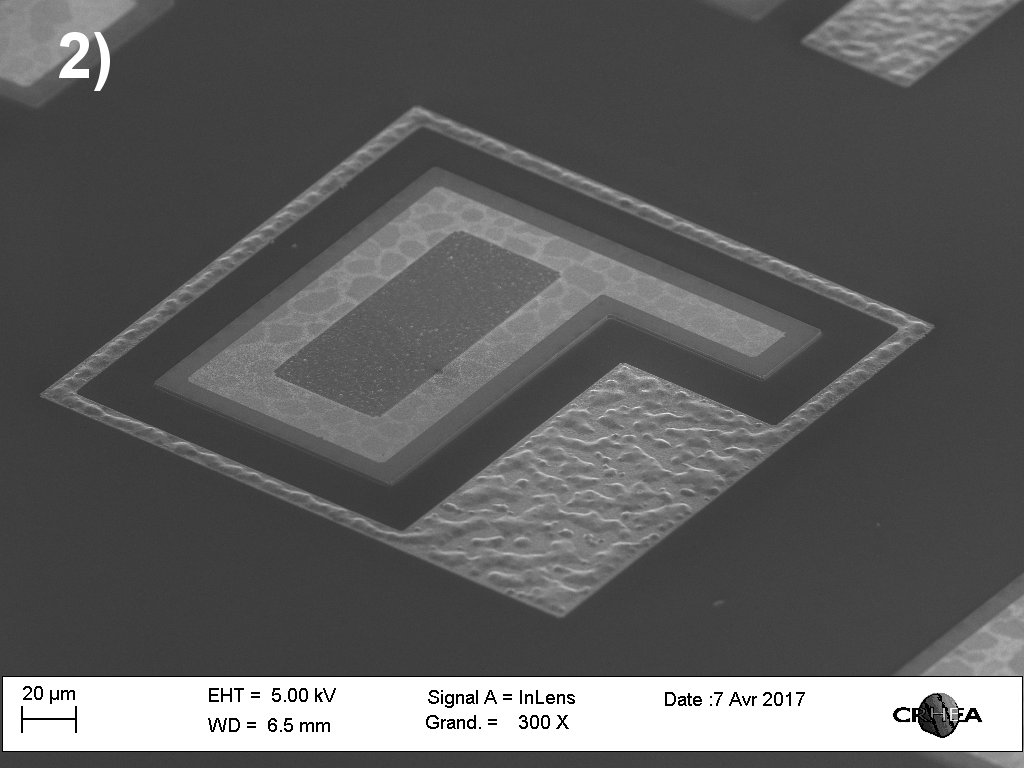
Les appareils utilisés sont décrits dans la page plateforme de technologie du CRHEA.
 Qui contacter ?
Qui contacter ?
- Pour toute question relative à la plateforme de technologie CRHEATEC: Sébastien Chenot


