Microscopie à force atomique
La microscopie à force atomique est mise en œuvre au laboratoire pour la caractérisation aux échelles micrométriques et nanométriques de la surface de semi-conducteurs (nitrures d’éléments III (Ga, Al, In), SiC, BN, MoS2, …), conducteurs (NbN, graphène, …) et isolants (saphir, MgO, …)) étudiés au laboratoire via la mesure des forces d’interaction qui s’exercent entre les atomes de la surface et les atomes de la pointe du microscope. Le mode d’imagerie principalement mis en œuvre au laboratoire est le mode intermittent (tapping mode TM).
La plateforme CRHEACAM dispose de deux microscopes à force atomique (AFM) fabriqués par la société Bruker.
D’une part, il s’agit du Nanoscope IV Dimension 3100 permettant d’imager des échantillons de taille maximale de 4 pouces avec un balayage en surface allant de 0,25 mm2 à 2500 mm2.
D’autre part, il s’agit du Dimension Edge doté du mode TM qui présente des caractéristiques similaires au Dimension 3100 et permettant d’étudier des échantillons de taille maximale de 8 pouces sans découpe. Cette spécificité non destructive est bénéfique pour caractériser la surface des substrats de plus grandes tailles importants pour l’élaboration d’un plus grand nombre de composants. De plus, il présente la possibilité d’une gestion automatique de l’acquisition via le mode Peak force ScanAsyst pour réduire l’usure des pointes. Son principe de fonctionnement consiste à faire osciller la pointe en silicium bien en dessous de sa fréquence de résonnance où la boucle d’asservissement maintient constant la force maximale de chaque interaction entre la pointe et l’échantillon.

AFM Dimension 3100 :
- Résolution latérale de 5 nm
- Résolution verticale de 10 pm
- Caractéristiques du mode TM :
- Constante de raideur (k) de 42 N/m
- Fréquence de résonnance (f0) de 320 kHz

AFM Dimension Edge
- Résolution latérale de 5 nm
- Résolution verticale de 10 pm
- Caractéristiques du mode TM :
- Constante de raideur (k) de 42 N/m
- Fréquence de résonnance (f0) de 320 kHz
- Caractéristiques du Peak force ScanAsyst :
- Constante de raideur (k) de 0,4 N/m
- Fréquence de résonnance (f0) de 70 kHz
Quelques images AFM :
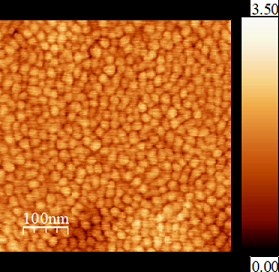 Image topographique AFM d’un film semi-conducteur ScAlN sur GaN, présentant des propriétés piézoélectriques exceptionnelles pour l’électronique
RF (transistors, filtres) ou la commutation de puissance, qui a permis de déterminer l’uniformité de la croissance et la faible rugosité (RMS = 0,3 nm).
Image topographique AFM d’un film semi-conducteur ScAlN sur GaN, présentant des propriétés piézoélectriques exceptionnelles pour l’électronique
RF (transistors, filtres) ou la commutation de puissance, qui a permis de déterminer l’uniformité de la croissance et la faible rugosité (RMS = 0,3 nm).
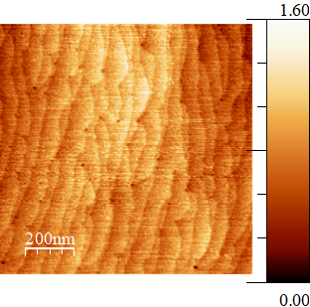 Image topographique AFM de la surface d’une couche semi-conductrice AlN (épaisseur = 1 mm) déposée sur un substrat AlN (épaisseur = 200 nm) / saphir,
correspondant à la couche tampon pour l’élaboration des structures LED UV, qui a servi à identifier et à déterminer la densité de dislocations
(d= 4,7 x 109 dislocations/cm2).
Image topographique AFM de la surface d’une couche semi-conductrice AlN (épaisseur = 1 mm) déposée sur un substrat AlN (épaisseur = 200 nm) / saphir,
correspondant à la couche tampon pour l’élaboration des structures LED UV, qui a servi à identifier et à déterminer la densité de dislocations
(d= 4,7 x 109 dislocations/cm2).
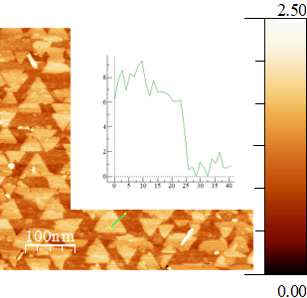 Image topographique AFM de flocons semi-conducteurs MoS2 sur GaN, possédant un fort potentiel pour la réalisation de transistors « FET »,
photo-détecteurs ou biocapteurs, qui a permis de déterminer l’épaisseur de MoS2 d’environ 0,7 nm représentant une monocouche.
Image topographique AFM de flocons semi-conducteurs MoS2 sur GaN, possédant un fort potentiel pour la réalisation de transistors « FET »,
photo-détecteurs ou biocapteurs, qui a permis de déterminer l’épaisseur de MoS2 d’environ 0,7 nm représentant une monocouche.
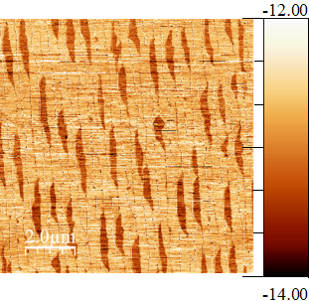 Image de phase AFM de graphène sur SiC, utilisé pour la fabrication d’étalons de résistance à effet Hall quantique en métrologie électrique,
révélant la non-uniformité de la dureté de la surface et donc la présence de monocouches et de bicouches de graphène.
Image de phase AFM de graphène sur SiC, utilisé pour la fabrication d’étalons de résistance à effet Hall quantique en métrologie électrique,
révélant la non-uniformité de la dureté de la surface et donc la présence de monocouches et de bicouches de graphène.


