Electronique RF
Dans le domaine des composants RF à base de GaN, les communautés académique et industrielle ambitionnent de démontrer des composants fonctionnant à des fréquences au-delà de 40 GHz avec des figures de mérite telles qu’une puissance de sortie et un rendement de puissance ajoutée les plus élevés possible. Cette recherche s’effectue dans un contexte économique et stratégique particulièrement tendu où il est primordial de développer des solutions garantissant une indépendance notamment par rapport aux matériaux critiques et/ou énergétiquement couteux à fabriquer
L’activité RF au CRHEA s’inscrit parfaitement dans ce contexte puisqu’elle est en partie orientée vers le développement d’hétérostructures épitaxiées sur substrat silicium grande surface (substrat jusqu’à 200 mm de diamètre) en vue de fournir des solutions à plus faible coût. En s’appuyant sur une expérience historique et unique dans le domaine de l’épitaxie sur substrat silicium (débutée à la fin des années 90) et en intégrant des nouveaux matériaux tels que ScAlN et NbN, le CRHEA se donne les chances de jouer un rôle majeur dans le domaine. Afin d’être à la fois innovants et compétitifs, l’équipe SEMI développe actuellement les 4 approches suivantes :
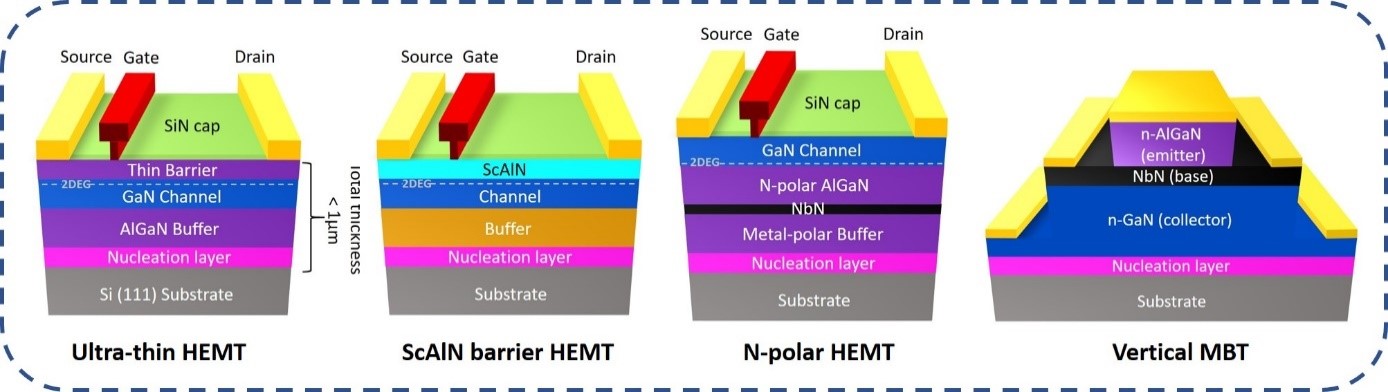
Sur la base de ce qui a été développé au CRHEA sur substrat silicium en Epitaxie sous Jets Moléculaires (EJM),[1] les structures épitaxiées sur Si 200 mm dans le cadre du projet Hypergan (collaboration CRHEA-IEMN-EasyGaN) ont maintenant atteint un niveau de performances sans précédent.[2,3] Pour une épaisseur totale inférieure au micromètre (ultra-thin HEMT structure), une puissance de sortie (Pout) de 2.5 W/mm et une PAE de 19.2% ont été obtenues à 40GHz.[3]
Une alternative prometteuse est également développée au CRHEA et consiste à remplacer la barrière (Al,Ga)N par une fine couche de ScAlN afin de garantir une densité de porteurs élevée, et ainsi conserver une forte densité de puissance même à des hautes fréquences. L’équipe SEMI étudie également des structures à base de NbN, matériau qui permet d’obtenir la polarité azote dans les matériaux nitrures, ce qui théoriquement peut améliorer significativement les performances des transistors pour les applications RF. Par ailleurs l’insertion du NbN dans une hétérostructure de nitrures d’éléments III est aussi à l’étude pour démontrer un transistor à base métallique qui devrait être significativement plus performant que le transistor « classique » HEMT pour des applications RF.
En parallèle des différentes approches développées par épitaxie sous jets moléculaires (EJM), l’équipe SEMI a également mis en évidence les mécanismes à l’origine des pertes de propagation limitant les performances RF des structures élaborées sur Silicium par épitaxie en phase vapeur aux organométalliques (EPVOM).[4] Afin d’éviter cette conduction parasite, une alternative originale utilisant une couche tampon de 3C-SiC a été proposée et a permis de réduire significativement les pertes de propagation (inférieure à 0.8 dB.mm-1 à 40GHz).[5] L’utilisation de cette couche tampon est d’autant plus prometteuse qu’une structure HEMT élaborée par EPVOM au CRHEA, directement sur un substrat de SiC, a récemment permis d’atteindre 3.8W/mm de puissance de sortie avec une PAE de 42.8%.[6] A noter que cette démonstration a fait appel à l’épitaxie sélective par EJM de GaN fortement dopé N+ pour obtenir des contacts ohmiques non alliés.
Sur le plan national, l’activité RF du CRHEA s’appuie sur des collaborations solides établies avec l’IEMN, le LN2, 3-5 lab et l’implication plus récente de partenaires académiques tels que le GREMAN, le GREYC mais aussi industriels comme STMicroelectronics. En hébergeant la société NOVASiC (filiale de SOITEC) et la startup EasyGaN (spin-off du CRHEA), le CRHEA peut faire le lien entre la recherche académique et les projets industriels via la fabrication de produits en petite/moyenne série ce qui est un élément déterminant pour évaluer les performances et la pertinence des différentes solutions envisagées.
- [1] - Assessment of transistors based on GaN on silicon substrate in view of integration with silicon technology – Semicond. Sci. Technol. 28, 094003 (2013).
- [2] - Submicrometer-Thick Step-Graded AlGaN Buffer on Silicon with a High-Buffer Breakdown Field – Phys. Stat. Sol (a) 220, 2200846 (2023) – https://doi.org/10.1002/pssa.202200846
- [3] - Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate – Electronics 12, 2974 (2023) – https://doi.org/10.3390/electronics12132974
- [4] - Electrical activity at the AlN/Si Interface: identifying the main origin of propagation losses in GaN-on-Si devices at microwave frequencies – Sci Rep 10, 14166 (2020) – https://doi.org/10.1038/s41598-020-71064-0
- [5] - Metalorganic Chemical Vapor Phase Epitaxy Growth of Buffer Layers on 3C-SiC/Si(111) Templates for AlGaN/GaN High Electron Mobility Transistors with Low RF Losses – Phys. Stat. Sol (a) 217, 1900760 (2020) – https://doi.org/10.1002/pssa.201900760
- [6] - Performance improvement with non-alloyed ohmic contacts technology on AlGaN/GaN High Electron Mobility Transistors on 6H-SiC substrate – Microelectronic Engineering 276, 111998 (2023) – https://doi.org/10.1016/j.mee.2023.111998


