Electronique de puissance
Dans notre quotidien le besoin de convertir l'énergie électrique en tension et en courant utilisables pour alimenter mais aussi recharger une multitude d’objets (téléphone portable, ordinateur, voiture électrique, etc) n’a cessé de s’accroitre. Cette conversion est le plus souvent réalisée au moyen d’un transformateur qui hélas est le siège de pertes plus ou moins importantes. Il est donc primordial de développer des transformateurs permettant de réduire significativement ces pertes mais aussi de réduire leur taille et leur coût. C’est dans cette optique que de nombreux groupes académiques mais aussi des industriels développent aujourd’hui des composants à base de matériaux dits à « grand gap » comme le carbure de silicium (SiC), et les nitrures de gallium (GaN) et d’aluminium (AlN)
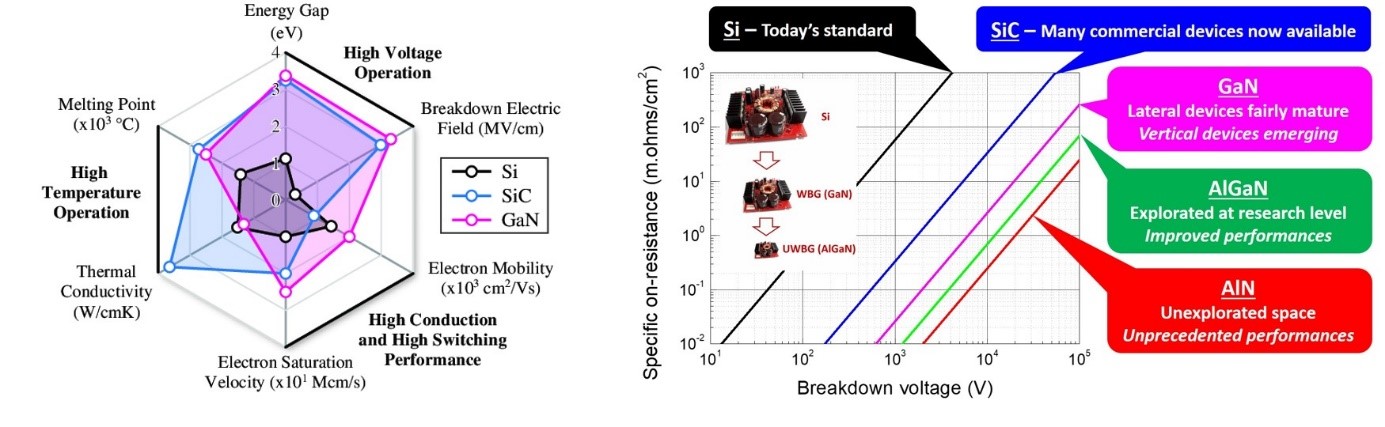
Le développement de l’épitaxie de matériaux III-N pour l’électronique de puissance a débuté au CRHEA à la fin des années 2000. Fort de son expertise en épitaxie, mais aussi en développant de nouvelles structures, le CRHEA est devenu un des acteurs nationaux incontournables dans ce domaine. De très nombreux projets au niveau national (ANR, labex GaNeXT, IPCEI, PEPR Electronique) et au niveau Européen (ECSEL JU GaN4AP) ont été initiés avec des partenaires académiques (IEMN, LAAS, AMPERE, GREMAN, LN2, CNR-IMM...) mais aussi industriels (STMicrolectronics, NOVASIC/SOITEC,…) et des établissements tels que le CEA-LETI.
Actuellement, cette activité suit la tendance mondiale qui est l’augmentation des tensions de claquage dans la filière des matériaux III-N sur substrat Silicium. L’objectif est de dépasser les 650V pour des transistors de type HEMT (High Electron Mobility Transistor). Au CRHEA cet objectif est actuellement adressé via l’augmentation de la teneur en aluminium dans la structure [1,2]. D’autre part, la réduction des résistances d’accès est adressée à travers le développement du ScAlN comme nouveau matériau barrière [3] tandis que l’épitaxie localisée est utilisée pour augmenter les épaisseurs des couches tampon [4] ainsi que pour développer des composants « normally-off » [5]. De plus, dans le cadre des actions IPCEI (Nano 2022, Nano 2025) pilotées par STMicroelectronics, la validation d’un procédé hybride d’épitaxie (template AlN/Si en MBE puis reprise de croissance en MOCVD) est en cours avec la startup EasyGaN issue du CRHEA.
Un autre axe de recherche est le développement de dispositifs de puissance verticaux à base de matériaux III-N. Des diodes Schottky et des jonctions p-n sont fabriquées sur des substrats de GaN pour valider la qualité du matériau mais aussi celle des procédés technologiques réalisés (projet ECSEL JU GaN4AP, labex GaNeXT VERTIGaN, ANR C-Pi-GaN). Ces dispositifs servent de référence [6] pour étudier les structures développées par hétéroépitaxie sur des substrats Saphir et Silicium (projet ciblé VERTIGO du PEPR Electronique, projet ANR ELEGANT, IPCEI Nano 2025). Des transistors verticaux de type FINFET et MOSFET sont également développés de même que l’épitaxie localisée de GaN est étudiée pour faciliter l’hétéro-épitaxie sur substrat Silicium [7].
- [1] - High Al-content AlGaN channel high electron mobility transistors on silicon substrate – e-Prime - Advances in Electrical Engineering, Electronics and Energy 3, 100114 (2023) - https://doi.org/10.1016/j.prime.2023.100114
- [2] - Effects of GaN channel downscaling in AlGaN-GaN high electron mobility transistor structures grown on AlN bulk substrate – J. Appl. Phys., 133, 145705, (2023) – https://doi.org/10.1063/5.0147048
- [3] - Influence of the temperature on growth by ammonia source molecular beam epitaxy of wurtzite phase ScAlN alloy on GaN – APL Materials, 11, 031105, (2023) – https://doi.org/10.1063/5.0139588
- [4] - Epitaxial growth of AlGaN/GaN HEMTs on patterned Si substrate for high voltage power switching applications – Microelectron Eng, 277, 112017, (2023) – https://doi.org/10.1016/j.mee.2023.112017
- [5] - Selective sublimation of GaN and regrowth of AlGaN to co-integrate enhancement mode and depletion mode high electron mobility transistors – J. Cryst. Growth, 593, 126779, (2022) – https://doi.org/10.1016/j.jcrysgro.2022.126779
- [6] - Comprehensive characterization of vertical GaN-on-GaN Schottky barrier diodes – Microelectronics J, 128, 105575, (2022) – https://doi.org/10.1016/j.mejo.2022.105575
- [7] - Characterization of unintentional doping in localized epitaxial GaN layers on Si wafers by scanning spreading resistance microscopy – Microelectron Eng, 273, 111964, (2023) – https://doi.org/10.1016/j.mee.2023.111964


