Electronique de puissance
Les composants électroniques de puissance permettent de gérer au mieux l’énergie électrique. En comparaison avec le Silicium, les matériaux à base de semiconducteurs à large bande interdite comme GaN et SiC présentent de nombreux avantages pour fabriquer des interrupteurs (transistors) ou des redresseurs de puissance (diodes). Parmi ces avantages on compte la possibilité pour les composants de présenter de plus faible résistances électriques à l’état passant (plus faibles pertes) tout en supportant de plus grandes densités de courant ainsi que de plus fortes tensions à l’état bloqué. Dans ce contexte, l’équipe ELECTRO héberge l’activité épitaxie SiC de la société NOVASiC et développe l’épitaxie d’hétérostructures HEMTs (High Electron Mobility Transistors) Al(Ga)N/GaN sur différents substrats (Si, SiC, Saphir, GaN, AlN…). Parmi ces substrats, le Silicium est celui qui concentre le plus les efforts en raison des perspectives de développements industriels offertes à grande échelle.
Les transistors utilisés comme interrupteurs de puissance présentent des tensions de claquage qui dépendent de l’épaisseur et de la qualité des couches épitaxiées sur le substrat Silicium. Comme on peut le voir ci-dessous, ces transistors montrent des tensions de claquage qui peuvent dépasser 700V en configuration verticale pour une structure épaisse de 2 µm seulement.
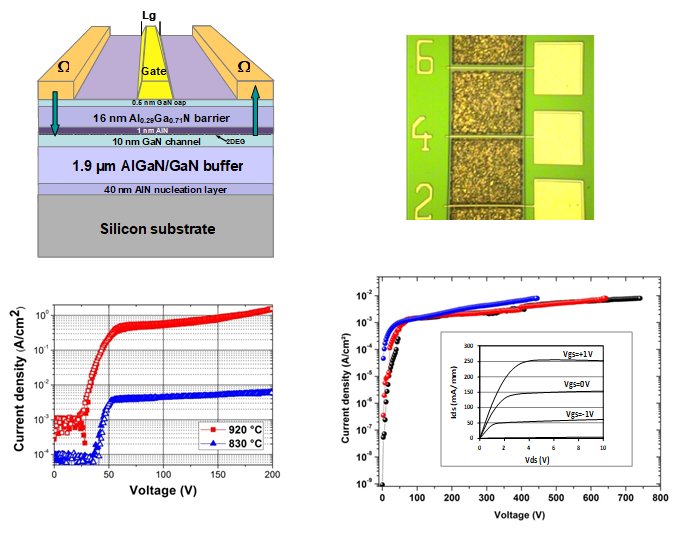
La croissance de GaN pour la réalisation de diodes Schottky verticales ou pseudo-verticales (2) a également été développée pour des redresseurs de puissance.
Un point important actuellement est le développement de transistors « normally-off », que ce soit pour des interrupteurs de puissance ou des circuits de télécommunications avancés. Dans ce but, le laboratoire développe des solutions originales basées sur l’épitaxie localisée (collaborations LAAS, LN2). Cette dernière est également développée pour la co-intégration monolithique de composants GaN avec l’électronique C-MOS Silicium (3)(4).
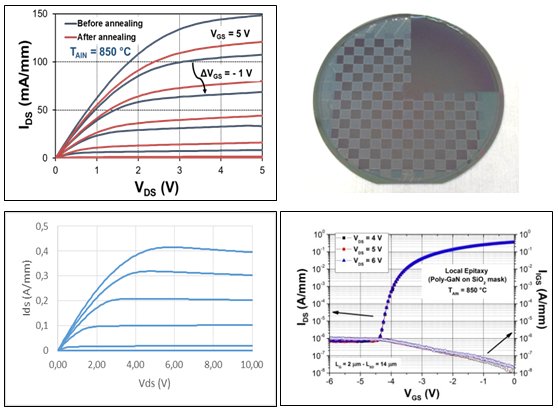
Principales collaborations
IEMN, LAAS, LN2, GREMAN
Références :
- Influence of AlN Growth Temperature on the Electrical Properties of Buffer Layers for GaN HEMTs on Silicon
- Growth of thick GaN layers on 4-in. and 6-in. silicon (111) by metal-organic vapor phase epitaxy
- Development of technological building blocks for the monolithic integration of ammonia-MBE-grown GaN-HEMTs with silicon CMOS
- Reduction of the thermal budget of AlGaN/GaN heterostructures grown on silicon: A step towards monolithic integration of GaN-HEMTs with CMOS


